世界芯片切割市场的较大份额,特别是在非集成电路晶圆划片领域。金刚石锯片(砂轮)划片方法是目前常见的晶圆划片方法。,传统刀片进行划片极易导致晶圆破碎,且划片速度较慢,切割刀片需要频繁的更换,后期运行成本较高。
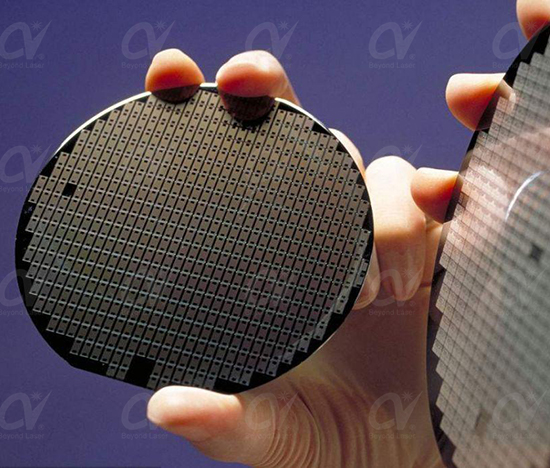
新型划片-激光,激光属于无接触式加工,不对晶圆产生机械应力的作用,对晶圆损伤较小。 由于激光在聚焦上的优点, 聚焦点可小到亚微米数量级, 从而对晶圆的微处理更具优越性, 可以进行小部件的加工; 即使在不高的脉冲能量水平下, 也能得到较高的能量密度, 有效地进行材料加工。

加工优势:

微信公众号

手机微网站
深圳市超越激光智能装备股份有限公司 粤ICP备11096299号 安全联盟  粤公网安备 44030702002291号
粤公网安备 44030702002291号
【免责声明】网站内容部分来自网络.若有侵权行为请告知网站管理员.本网站将立即给予删除【版权声明】若无告之盗用本站信息,违者必究,决不姑息!

![]()

![]()


