MEMS(Micro-Electro-Mechanical System)即微电子机械系统,一般由微机械结构、微传感器、微执行器和控制电路组成,MEMS是通过半导体工艺实现不同能量形式之间的转换的一种芯片。
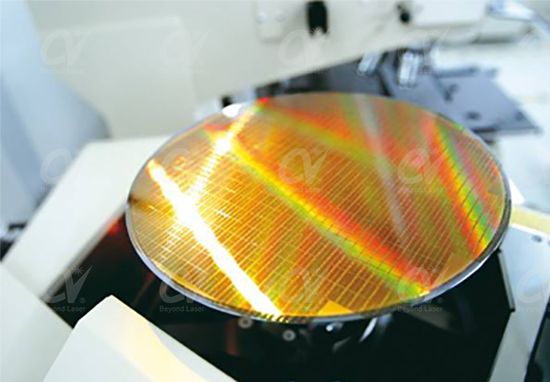
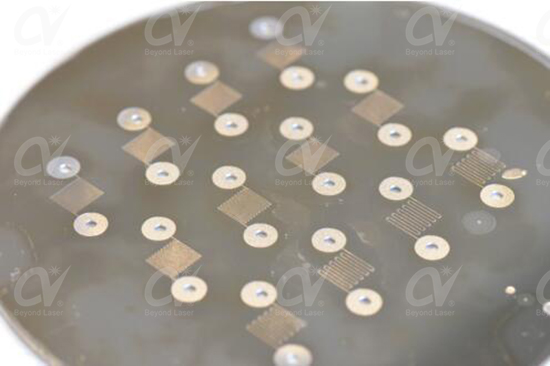
MEMS晶圆的划片方法不同于典型IC的划片。典型IC砂轮划片是通过砂轮刀片高速旋转来完成材料的去除,从而实现芯片切割。由于刀片的高速旋转,往往需要使用纯水进行冷却和冲洗,那么刀片高速旋转产生的压力和扭力,纯水的冲洗产生的冲击力以及切割下来的Si屑造成的污染都容易对MEMS芯片中机械微结构造成不可逆的破坏。所以典型IC的砂轮划片不适用MEMS晶圆的划片。
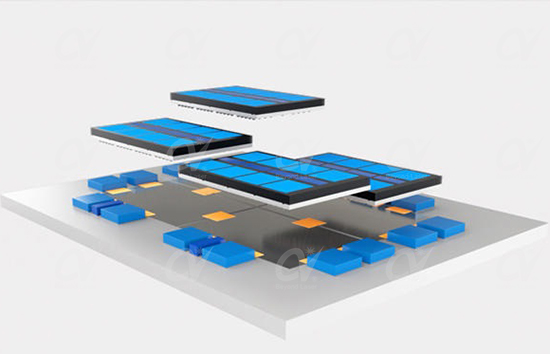
激光隐形切割作为激光切割晶圆的一种方案,很好的避免了砂轮划片存在的问题。激光隐形切割是通过将脉冲激光的单个脉冲通过光学整形,让其透过材料表面在材料内部聚焦,在焦点区域能量密度较高,形成多光子吸收非线性吸收效应,使得材料改性形成裂纹。每一个激光脉冲等距作用,形成等距的损伤即可在材料内部形成一个改质层。在改质层位置材料的分子键被破坏,材料的连接变的脆弱而易于分开。切割完成后通过拉伸承载膜的方式,将产品充分分开,并使得芯片与芯片之间产生间隙。这样的加工方式避免了机械的直接接触和纯水的冲洗造成的破坏。目前激光隐形切割技术可应用于蓝宝石/玻璃/硅以及多种化合物半导体晶圆。
(本文由超越激光整理原创,转载须注明出处:www.beyondlaser.com,请尊重劳动成果,侵犯版权必究)

微信公众号

手机微网站
深圳市超越激光智能装备股份有限公司 粤ICP备11096299号 安全联盟  粤公网安备 44030702002291号
粤公网安备 44030702002291号
【免责声明】网站内容部分来自网络.若有侵权行为请告知网站管理员.本网站将立即给予删除【版权声明】若无告之盗用本站信息,违者必究,决不姑息!

![]()

![]()


